온디바이스 AI 확산에 발열 제어 중요성 커져
삼성전자 '초슬림 패키지' vs 하이닉스 '신소재'
[서울=뉴스핌] 김정인 기자 = 삼성전자와 SK하이닉스가 고성능 모바일 기기의 발열 문제 해결을 위한 새로운 방안을 내놓으며 차세대 메모리 시장에서 경쟁 구도를 한층 넓히고 있다. 온디바이스 인공지능(AI) 구현을 위해 데이터 처리 속도가 급격히 높아지는 가운데, 발열 제어 기술은 성능과 에너지 효율을 좌우하는 핵심 요소로 떠올랐다.
◆ 발열 대응, AI 스마트폰·차량용 메모리까지 확대
2일 업계에 따르면 글로벌 메모리 기업들은 온디바이스 AI 확산에 대응해 발열 문제를 차별화 포인트로 삼고 있으며, 고객사 요구에 맞춘 신소재·패키징 솔루션 개발에 속도를 내고 있다.
모바일 기기에서 발열은 단순한 불편을 넘어 성능 저하와 소비전력 증가로 직결된다. 특히 최신 플래그십 스마트폰은 모바일 애플리케이션프로세서(AP) 위에 D램을 적층하는 패키지온패키지(PoP) 구조를 채택하고 있어, 열이 메모리 내부에 축적되면 전체 성능이 떨어지는 문제가 나타난다. 업계에서는 방열 문제 해결 여부가 온디바이스 AI 경쟁력을 결정짓는 분기점이 될 것으로 본다.
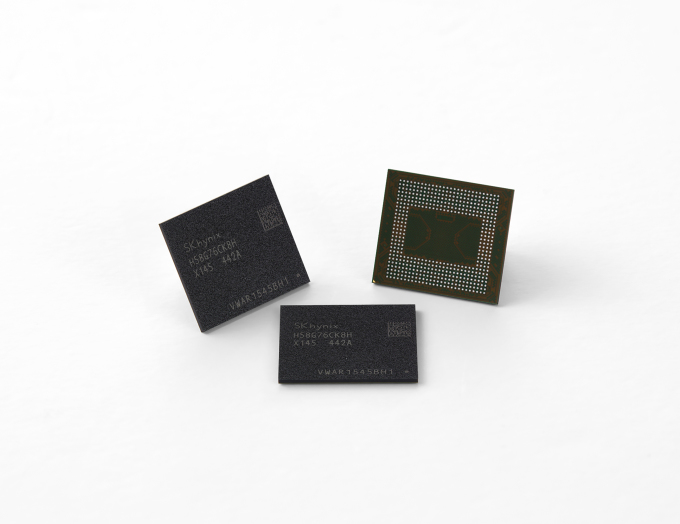
발열 대응 기술은 스마트폰에 국한되지 않는다. 웨어러블 기기, 전장용 반도체 등 고발열 환경에 놓인 응용처로 확대될 전망이다. 실제로 차량용 D램과 차세대 고대역폭메모리(HBM)에서도 방열은 가장 큰 과제 중 하나로 꼽힌다. 글로벌 메모리 기업들이 소재와 구조 양 측면에서 방열 솔루션 고도화에 속도를 내는 이유다.
◆ 하이닉스는 '소재 혁신', 삼성은 '구조 혁신'
SK하이닉스는 업계 최초로 'High-K EMC(Epoxy Molding Compound)' 소재를 적용한 고방열 모바일 D램을 개발해 글로벌 고객사에 공급을 시작했다. 기존 실리카 대신 알루미나를 혼합한 신소재를 적용해 열전도도를 3.5배 높이고 수직 열 저항은 47% 낮췄다.
SK하이닉스는 온디바이스 AI 구현을 위한 데이터 고속 처리 시 발생하는 발열이 스마트폰 성능 저하의 주요 원인이 되고 있다"며 "이번 제품으로 고사양 플래그십 스마트폰의 발열 문제를 해결해 글로벌 고객사들로부터 높은 평가를 받고 있다"고 설명했다.

삼성전자는 소재가 아닌 패키지 구조 혁신을 선택했다. 회사는 지난해 업계에서 가장 얇은 0.65mm 두께의 저전력더블데이터레이트(LPDDR)5X 패키지를 양산하면서 발열 성능을 약 21% 향상시켰다. 또 기존 대비 두께를 9% 줄여 모바일 AP와 메모리 사이 공간 활용도를 높였고, 자연적인 공기 흐름을 통한 방열 효과를 극대화했다.
결국 SK하이닉스는 신소재 적용을 통한 내부 발열 경로 개선에, 삼성전자는 초슬림 패키지를 통한 외부 냉각 효율 강화에 각각 무게를 두고 있다. 두 회사가 같은 발열 문제를 전혀 다른 해법으로 풀어내는 것은, 메모리 시장에서 고객 요구가 초저전력·초고성능·슬림한 폼팩터 등으로 세분화·다변화되고 있기 때문이라는 분석이 나온다.
업계 관계자는 "온디바이스 AI 확산으로 모바일 메모리에서 발열은 단순한 기술 과제가 아니라 시장 성공을 좌우하는 요소가 됐다"며 "삼성과 하이닉스가 각각 다른 접근법을 내놓은 것은 고객 요구가 그만큼 다양해졌다는 의미"라고 말했다.
kji01@newspim.com
![[IR핌] 캠시스, 신사업 'AI카메라·IoT 태그' 추진…"초도 물량 본격화"](https://img.newspim.com/news/2025/09/01/2509011432482640_w.jpg)

![[나노 혁신, 미래를 설계하다] 〈8〉 '반백년' 상보, 나노코팅 기술로 100년 기업 도약](https://img.etnews.com/news/article/2025/09/02/news-p.v1.20250902.48f1e1fb996d455798a3f2cdb5fbd1e2_P1.jpg)
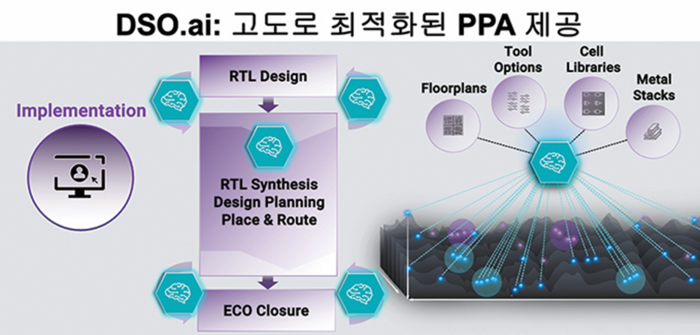
![[소부장 인사이트] 차세대 3D 낸드를 위한 'z피치 스케일링' 기술](https://img.etnews.com/news/article/2025/08/21/news-p.v1.20250821.2b9e98d51ec443b89bee5ed76fda5882_P3.png)

![[ET시론]AI 혁신, 생산성의 패러독스를 넘어 '모두의 AI'로](https://img.etnews.com/news/article/2025/08/29/news-p.v1.20250829.4e4c1c7371ba427c8cfd155434a04574_P3.png)
![[KPCA쇼]AI 시대 대응 '반도체 유리기판과 첨단 패키징' 기술 한눈에…KPCA쇼 개막](https://img.etnews.com/news/article/2025/09/02/news-p.v1.20250902.a56084822c934f588b3c04087333ee1b_P1.png)