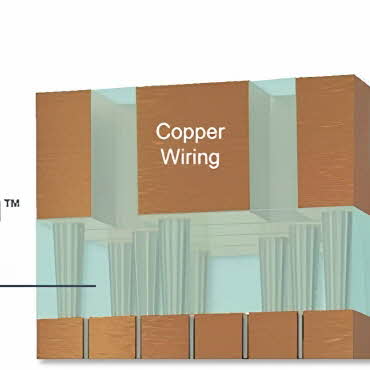
전세계 첨단 반도체 및 디스플레이를 위한 재료공학 솔루션 선도 기업 어플라이드 머티어리얼즈가 가 2나노(nm) 로직 노드 이하로 구리 배선 스케일링을 가능케 함으로써 컴퓨터 시스템 와트당 성능을 높이는 재료공학 혁신을 발표했다.
프라부 라자(Dr. Prabu Raja) 어플라이드 머티어리얼즈 반도체 제품그룹 사장은 “AI 시대에는 에너지 효율이 더욱 높은 컴퓨팅이 요구되고, 성능 및 전력 소비에서 칩 배선과 적층이 매우 중요하다”며, “어플라이드 최신 통합 재료 솔루션은 반도체 업계가 저저항 구리 배선을 옹스트롬(Angstrom) 노드로 스케일링 할 수 있도록 한다. 또한 어플라이드의 최신 로우k(low-k) 유전체(dielectric)는 정전용량(capacitance)을 낮추고 칩을 강화해 3D 적층의 차원을 높인다”고 말했다.
무어의 법칙 물리적 스케일링 과제 극복
오늘날 최첨단 로직 칩에는 수백억 개 트랜지스터가 96킬로미터 이상의 미세한 구리 배선으로 연결돼 있다. 칩 배선의 각 층(layer)은 구리로 채워진 채널을 만들기 위해 식각된 유전체 박막으로 시작된다. 로우k 유전체와 구리는 지난 수십년 간 반도체 업계에서 주로 사용된 조합으로 반도체 제조사들이 각 세대에서 스케일링, 성능, 전력 효율을 높이는데 큰 역할을 해왔다.
그러나 반도체 업계가 2나노 이하로 스케일링함에 따라 절연체가 얇아지면서 칩이 물리적으로 약해졌다. 구리 배선의 폭이 좁아지면 전기 저항이 가파르게 증가해 칩 성능이 저하되고 전력 소비량은 증가한다.
▲향상된 블랙 다이아몬드
향상된 로우K 유전체… 인터커넥션 3D 적층 위해 저항 낮추고 칩 강화
어플라이드의 ‘블랙 다이아몬드(Black Diamond)’ 소재는 전력 소비를 높이고 전기 신호 간 간섭을 초래하는 전하의 축적을 낮추기 위해 엔지니어링된 낮은 유전상수 또는 유전율(k-value) 박막으로 구리 배선을 감싸는 방식을 적용, 수십 년간 업계를 선도해왔다.
어플라이드는 ‘프로듀서(Producer) 블랙 다이아몬드 PECVD’ 제품군에서 가장 최신형인 블랙 다이아몬드 향상된 버전을 발표했다. 이 신소재는 최소 유전율을 낮춰 2나노 이하의 스케일링을 가능케 한다. 또한 반도체 제조사 및 시스템 업체가 3D 로직과 메모리 적층의 차원을 높이는데 있어 매우 중요해진 향상된 기계적 강성을 제공한다.
최신 블랙 다이아몬드 기술은 현재 모든 로직 및 D램 반도체 선도 기업들이 채택하고 있다.
새로운 이원 금속 라이너로 초박막 구리 배선 구현
반도체 제조사들은 칩 배선 스케일링을 위해 로우k 박막의 각 층을 식각해 트렌치(trench)를 생성하고, 구리가 칩으로 유입돼 수율 문제를 초래하는 것을 방지하는 배리어(barrier) 층을 증착한다. 이 배리어는 최종 증착 공정 중 접착력을 보장하는 라이너(liner)로 코팅 처리된다.
반도체 제조사들이 배선을 추가로 스케일링함에 따라 배리어와 라이너가 배선에서 차지하는 부피의 비율이 높아졌다. 이에 남은 공간에 공극(void) 발생 없는 저저항 구리 배선 생성은 물리적으로 불가능하다.
어플라이드 머티어리얼즈는 반도체 제조사들이 구리 배선을 2나노 노드 이하로 스케일링할 수 있도록 6개 기술을 하나의 고진공 시스템에 조합한 최신 IMS(통합 재료 솔루션)을 발표했다. 업계 최초 루테늄과 코발트(RuCo)의 이원(binary) 금속 조합은 라이너의 두께를 최대 33퍼센트인 2나노까지 축소한다. 공극 없는 구리 리플로(reflow)를 위한 표면 물성을 개선하고 전기 배선 저항을 최대 25퍼센트까지 낮춰 칩 성능과 전력 소비를 개선한다.
볼타 루테늄 CVD 기술이 적용된 어플라이드의 새로운 ‘엔듀라 쿠퍼 배리어 씨드 IMS(Endura Copper Barrier Seed IMS)’는 모든 선도 로직 반도체 제조사가 채택해 3나노로 고객 출하를 시작했다. 기술에 대한 자세한 설명과 영상은 어플라이드 웹사이트에서 확인 가능하다.
김선정 삼성전자 파운드리 개발팀 상무는 “패터닝 발전이 소자의 지속적인 스케일링을 견인하고 있지만 인터커넥트 배선 저항, 정전용량, 신뢰성 등 풀어야 할 과제가 남아 있다”며 “삼성은 이 문제들을 해결하기 위해 스케일링의 이점을 가장 진보한 노드까지 확대하는 다양한 재료 공학 혁신을 채택하고 있다”고 말했다.
미위제(Y.J. Mii) TSMC 수석 부사장 겸 공동 최고운영책임자(COO)는 “AI 컴퓨팅의 지속 가능한 성장을 위해 반도체 업계는 에너지 효율적인 성능을 획기적으로 개선해야 한다”며 “인터커넥트 저항을 낮추는 신소재는 다른 혁신과 함께 전반적인 시스템 성능과 전력을 개선하며 반도체 산업에서 중요한 역할을 할 것”이라고 전했다.
배선 분야 어플라이드 기회 확대
7나노에서 3나노 노드로 전환됨에 따라 인터커넥트 배선 공정 규모는 약 3배로 커졌다. 이에 따라 배선 분야에서 어플라이드 시장 잠재력은 그린필드 용량 기준 10만 WSPM(Wafer-Starts-per-Month)당 10억 달러 이상으로 확대되며 총 60억 달러로 증가했다. 향후 후면전력공급 도입으로 배선 분야 어플라이드의 시장 잠재력은 10만 WSPM당 10억 달러까지 추가 확대되면서 총 70억 달러로 예상된다.
![[단독] 삼성 파운드리, 차세대 EUV 필수 소재 개발 …"상용화 청신호"](https://newsimg.sedaily.com/2024/10/14/2DFKF33F3F_2.png)



![[K-제조, 현장을 가다]<10>밥솥 핵심기술 종합주방가전에 이식 '쿠쿠전자 기술본부'](https://img.etnews.com/news/article/2024/10/11/news-p.v1.20241011.652def84bd6b4a4fa66c2a5117f3b3c8_P1.jpg)

![[테크체크] 수직 세상을 정복하다 - 승월로봇 기술](https://betanews.net/images/cmenu/print.gif)

