인텔 최고경영자(CEO) 립부 탄(=사진)이 파운드리 사업 재건 의지를 밝혔다.
립부 탄은 29일(현지시각) 미국 산호세에서 열린 ‘인텔 파운드리 다이렉트 커넥트’ 행사에서 “최첨단 공정 기술, 첨단 패키징, 제조 수요를 충족하도록 세계적 수준의 파운드리를 구축하기 위해 최선을 다하고 있다”며 “고객 목소리에 귀 기울이고 고객의 성공을 지원하는 솔루션을 만들어 신뢰를 얻는 게 최우선 임무”라고 밝혔다.
이날 인텔은 파운드리 고객사의 신뢰를 확보하기 위해 ▲공정 기술 ▲패키징 ▲미국 내 생산 체제 ▲생태계 지원 등의 사업 현황을 공유했다.
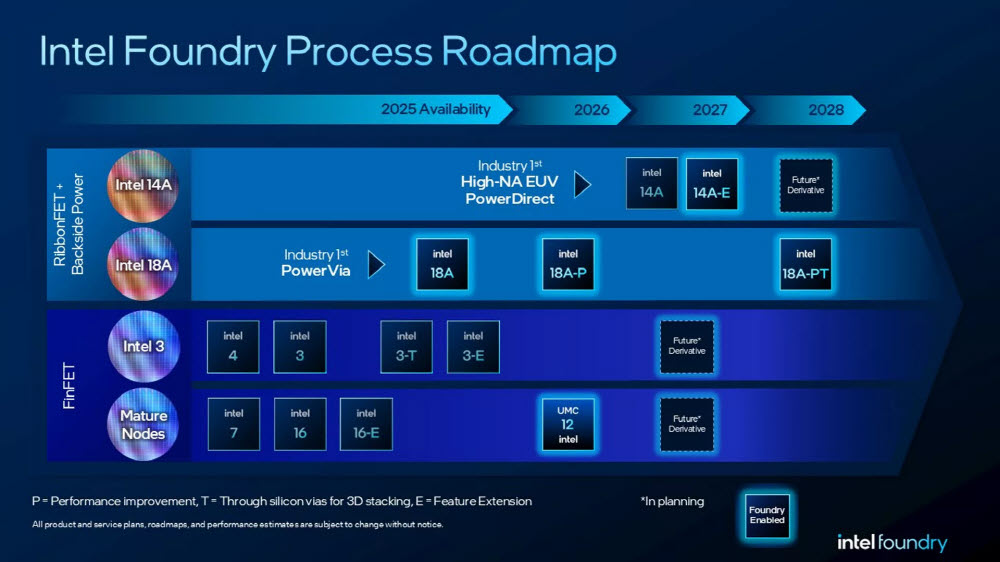
인텔은 현재 18A 노드 공정이 리스크 프로덕션 단계에 있으며 연내 양산을 시작할 예정이라고 밝혔다. 리스크 프로덕션은 칩 생산 의뢰를 받지 않고 시험 생산하는 과정을 말한다. 회사는 18A의 성능을 강화한 18A-P, 성능과 전력 효율을 향상한 18A-PT 파생 노드도 공개했다. 두 노드는 각각 2026년과 2028년에 선보일 예정이다. 이중 18A-P 초기 웨이퍼는 이미 팹에 투입됐으며 IP(설계자산)·EDA(전자설계자동화) 파트너가 관련 지원 업데이트를 진행하고 있다고 인텔은 설명했다.
18A의 후속 공정인 14A 계획도 공개했다. 해당 공정부터 고개구율 극자외선(High-NA EUV) 장비를 본격 투입한다. 18A 공정에 적용했던 반도체 후면 전력 전달 기술 ‘파워비아’에서 발전한 ‘파워다이렉트’ 직접 접촉 전력 공급 기술을 사용한다. 인텔은 14A를 2027년 양산 목표로 추진하고 있으며 일부 고객이 테스트 칩 제작 의사를 전해왔다고 밝혔다.
또한 16nm(나노미터) 공정의 첫 양산용 테이프아웃(제조 라인에 반도체 설계 도면을 보내는 것)을 완료했으며, 대만 파운드리 업체 UMC와 협력해 12nm 노드와 파생 공정을 두고 고객사와 논의하는 중이라고 언급했다.
패키징 측면에서 인텔 파운드리는 ▲포베로스 다이렉트(3D 적층) ▲임베디드 멀티다이 인터커넥트 브리징(2.5D 브리징) ▲하이브리드 본딩 인터커넥트(HBI) 기술을 활용, 시스템 수준의 통합을 제공한다고 소개했다. 또한 신규 첨단 패키징 기술 제품에 미래의 고대역폭 메모리 수요를 지원하는 EMIB-T를, 포베로스 아키텍처에 포베로스-R과 포베로스-B 옵션을 추가한다고 알렸다. 회사는 앰코 테크놀로지와 협력해 고객이 필요로 하는 첨단 패키징 기술을 유연하게 선택할 수 있도록 지원하겠다고 덧붙였다.
인텔은 18A와 14A의 연구, 개발, 웨이퍼 생산까지 모두 미국 내에서 진행할 예정이다. 그 일환으로 애리조나주에 위치한 팹 52에서 첫 번째 18A 웨이퍼 공정을 완료했다며 미국 내 제조 체제를 순조롭게 구축하는 중이라고 언급했다. 18A 웨이퍼 양산은 올해 말 미국 오리건주에 위치한 팹에서 시작하고 2026년에 애리조나주로 전환할 계획이라고 인텔은 설명했다.
생태계 측면에서 인텔은 인텔 파운드리 액셀러레이터 얼라이언스에 ‘인텔 파운드리 칩렛 얼라이언스’와 ‘밸류 체인 얼라이언스’를 비롯한 신규 프로그램을 추가했다고 밝혔다. 인텔 파운드리 칩렛 얼라이언스는 상호운용성과 보안성을 확보한 칩렛 솔루션을 활용, 이용자가 목표로 하는 시장과 앱에 맞는 설계를 구현하도록 지원한다. 해당 얼라이언스는 정부 기관용 앱과 상업 시장을 위한 기술 인프라를 정의·구축하는 데 주력할 예정이다.
글. 바이라인네트워크
<이병찬 기자>bqudcks@byline.network

![[글로벌 AI 특허 출원 동향]엑스피오 로지스틱스, 지능형 선적 분석 및 라우팅 솔루션으로 물류 혁신 가속화](https://img.etnews.com/news/article/2025/04/28/news-p.v1.20250428.cf8f8a9008344071a3bdedbcb26b9aa6_P1.jpg)