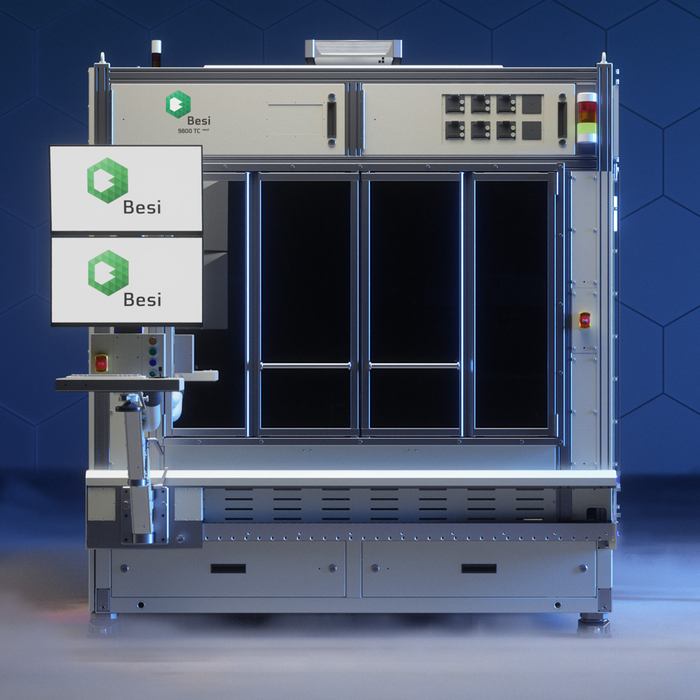
베시가 고대역폭메모리(HBM)용 열압착(TC) 본더를 3분기 출하한다. 경쟁사 대비 고정밀도를 갖춘 장비로 HBM4를 겨냥했다.
리처드 블릭만 베시 최고경영자(CEO)는 최근 2분기 실적 발표를 통해 “2분기 수주한 'TC 본딩 넥스트 시스템'를 3분기 말 또는 4분기 출하가 이뤄질 예정”이라며 “메모리를 위한 장비로 추가 주문은 4분기 또는 내년 1분기에 가능할 것으로 예상한다”고 밝혔다.
베시가 수주한 '칩 투 웨이퍼(C2W)' TC본더는 5대로, 약 2000만 유로(323억원) 규모다. 그동안 연구개발(R&D)을 진행해왔고, 올해 하반기 양산이 시작되는 HBM4를 시작으로 양산 장비로 시장에 진입하는 것으로 풀이된다.
베시는 TC본더를 시스템반도체(로직) 용도로 개발했지만 HBM4를 겨냥한 메모리 적층 테스트도 이뤄졌다고 소개했다.
장비 강점으로는 경쟁사 대비 높은 정밀도를 꼽았다. 블릭만 CEO는 “10마이크로미터(㎛) 이하 피치에서도 성공적으로 본딩을 수행할 수 있는 장비”라며 “하이브리드 본딩 도입 전까지의 영역에 대응할 수 있는 기술”이라고 강조했다.
베시는 HBM4E 16단 제품부터는 하이브리드 본더가 필요할 것으로 예상했다. 앞서 베시는 지난 1분기 메모리 제조사 두 곳으로부터 R&D 목적의 HBM용 하이브리드 본더를 수주했다고 밝힌 바 있다.
블릭만 CEO는 “(하이브리드 본딩이 적용된 HBM은) 2026년 제품 인증, 그리고 같은해 연말부터 혹은 2027년 본격 생산이 예정돼 있다”고 전했다.
박진형 기자 jin@etnews.com

![[사설] K-제조 강점은 좋은 협상 카드다](https://img.etnews.com/news/article/2025/07/30/news-a.v1.20250730.900c8846dfda44499d711f64ada53d5a_T1.jpg)
![[컨콜] 테슬라 탄 삼성전자..."추가 수주 기대"](https://img.newspim.com/news/2025/07/31/2507311108173050.jpg)



![[컨콜] 삼성SDI "유럽·美 전기차 배터리 수주 확대…ESS 4분기 美 현지 양산"](https://img.newspim.com/news/2025/04/25/2504251540532740.jpg)

![[GAM] '서학개미 픽' 에이아이 ②라이다 기술 강점 3가지와 염려](https://img.newspim.com/news/2025/07/31/2507310407151480.jpg)